從瑞利判據到數字光場:光刻分辨率的極限與工程實踐的權衡
日期:2025-12-05
在微納工程領域,將計算機輔助設計中的數字藍圖轉化為具有特定功能的物理器件,依賴于一系列精密的制造工藝,其中光刻技術無疑是定義器件幾何構型的基石,然而正如所有物理系統一樣,光學光刻的分辨率也受到其內在物理規律的制約。本文將從經典的光學理論出發,探討影響光刻分辨率的諸元,分析主流的分辨率增強技術,并最終聚焦于無掩模光刻這一新興范式,是如何在保證精度的前提下,為快速研發和多樣化應用提供獨特的價值。

理論的邊界:瑞利判據及其啟示
任何關于光刻分辨率的討論,都繞不開瑞利判據。

圖 瑞利判據:兩個相等強度的點光源,其中一個的中央極大值,剛好落在另一個的第一極小值
這個源于天文學家瑞利勛爵用于判斷望遠鏡分辨兩顆恒星能力的準則,同樣精準地描述了投影式光刻系統所能實現的最小特征尺寸。
CD=k1 * (λ / NA)
這個簡潔的公式揭示了決定光刻分辨率三大核心要素:
λ (波長): 曝光光源的波長。更短的波長意味著光波的衍射效應更弱,理論上能夠實現更精細的圖形。這也是光刻技術發展史上,光源從可見光(g-line 436nm, i-line 365nm)一路演進到深紫外(DUV, 248nm, 193nm),乃至極紫外(EUV, 13.5nm)的根本驅動力。
NA (數值孔徑): 投影物鏡系統的數值孔徑,代表了其收集光線的能力。NA值越大,意味著鏡頭可以接收更寬角度范圍的衍射光,從而保留更多圖形的細節信息,提升分辨率。
k1 (工藝因子): 這是一個綜合性的工藝相關系數,其值受到光刻膠性能、曝光工藝控制、分辨率增強技術(Resolution Enhancement Techniques, RET)應用等多種因素的影響。k1的理論物理極限為0.25。

圖 光刻系統原理圖
瑞利判據如同一座燈塔,為光刻技術的演進指明了三個方向:縮短波長(λ)、增大數值孔徑(NA)、以及降低工藝因子(k1)。 然而每一條路徑的探索都伴隨著巨大的技術挑戰和成本投入。光源波長的每一次躍遷都意味著整個光學系統、光刻膠材料乃至整個工藝生態的顛覆性變革。而NA值的提升也并非毫無代價,它往往會壓縮另一個關鍵參數——焦深,給工藝控制帶來更大挑戰。因此在工程實踐中,我們更多地是在這三個變量之間尋求一種動態的平衡與優化。
工程的智慧:突破衍射極限的“組合拳”
當特征尺寸不斷逼近光源波長時,光的衍射效應愈發顯著,單純依賴縮短波長和增大NA已顯得力不從心。為此,一代代光刻工程師們發展出了一系列精巧的“財技”——分辨率增強技術(RET),其核心思想在于通過優化照明方式和掩模版圖形,主動地“管理”衍射光場,以期在晶圓表面獲得更理想的成像。
浸沒式光刻: 這是在增大NA路徑上的一大創舉。傳統光刻機中,投影物鏡與晶圓之間是空氣(折射率n≈1)。浸沒式光刻則在二者間填充了高折射率的液體(如純水,193nm波長下n≈1.44),等效地將NA的天花板從1.0提升至1.44。這一技術的成功,極大地延長了193nm ArF光刻技術的生命周期,使其能夠支撐到45nm甚至更先進的工藝節點。
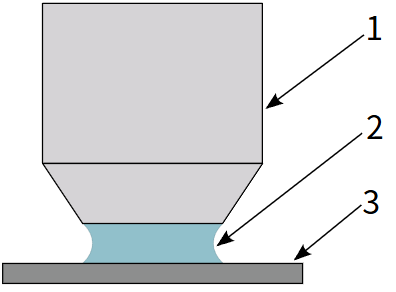
圖 在浸沒光刻中,來自上方的紫外線輻射先穿過一組透鏡(1)和一層薄液膜(2;此處為水),然后照射晶圓(3)表面的光刻膠
離軸照明(OAI): 傳統照明方式是光線垂直照射在掩模版上。OAI則通過特殊設計的照明光闌,使光線以一定角度傾斜照射。這種方式可以改變衍射光的空間分布,使得更高頻率的衍射級次能夠進入物鏡,從而增強特定方向(如密集線段)圖形的對比度和分辨率。
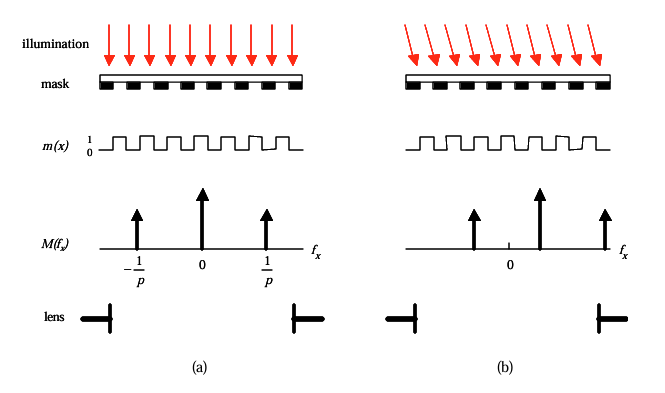
圖 離軸照明通過傾斜照明,改變了(a)中所示二元掩模的常規成像,導致(b)中所示的衍射圖案發生偏移
相移掩模(PSM): 傳統掩模版只控制光的“通”與“斷”(振幅)。PSM則在此基礎上,通過在特定區域引入厚度變化,額外控制透過光的“相位”。利用光波的干涉相消原理,可以在圖形邊緣形成更陡峭的光強梯度,從而獲得更清晰的成像。
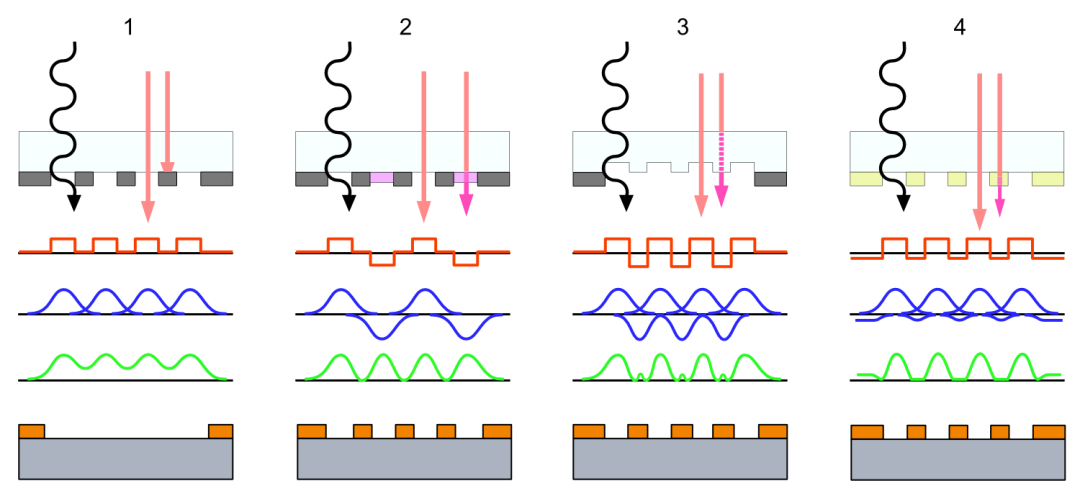
圖 相移掩模類型:(1)二元掩模,(2)相移掩模,(3)蝕刻石英掩模(萊文森掩模),(4)半色調掩模。(頂部)掩模,(紅色)掩模上的光能/相位,(藍色)晶圓上的光能/相位,(綠色)晶圓上的光功率,(底部)硅晶圓上的光刻膠
光學鄰近效應修正(OPC): 由于衍射效應,掩模版上的矩形在晶圓上可能會成像為圓角或者尺寸失真。OPC技術通過在設計階段預先對掩模版圖形進行“反畸變”處理,例如在尖角處添加輔助圖形或調整線條寬度,來補償成像過程中的光學失真。
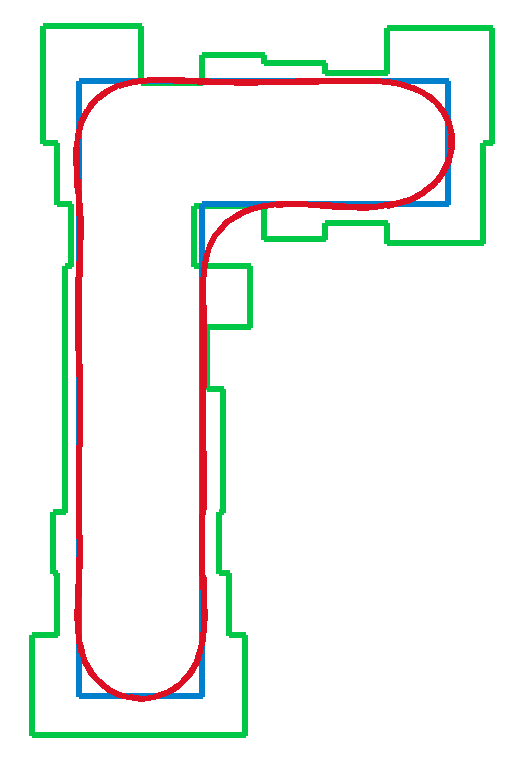
圖 一張OPC(光學鄰近校正)的示意圖。藍色的Γ形是芯片設計師希望印刷在晶圓上的形狀,綠色的是應用光學鄰近校正后掩模上的圖案,紅色的輪廓是該形狀實際印刷在晶圓上的樣子(與期望的藍色目標非常接近)
這些RETs技術往往組合使用,形成了極其復雜的計算光刻體系,使得光刻從一門“光學藝術”演變為一門依賴于海量計算和精密建模的“數據科學”。
范式轉移:無掩模光刻的靈活性與適用場景
盡管上述RETs技術極大地推動了大規模集成電路制造的進步,但它們高度依賴于一個核心部件——物理掩模版。掩模版的制造不僅成本高昂,且制作周期長,一旦設計有變,整套掩模版便面臨作廢,這對于研發、原型驗證和小批量生產場景而言,無疑是巨大的時間和成本障礙。
正是在這樣的背景下,無掩模光刻技術應運而生,它摒棄了物理掩模,轉而采用一個可實時編程的“數字掩模”來直接生成曝光圖案。目前,基于數字微鏡器件(DMD)的無掩模光刻是其中最主流的技術路徑之一。
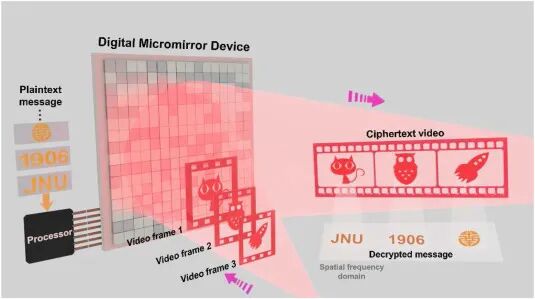
圖 DMD圖像技術概述
DMD是一種由數百萬個微米級的、可獨立高速翻轉的微型反射鏡組成的半導體光開關陣列。通過計算機精確控制每個微鏡的偏轉角度(“開”或“關”),就可以實時構建出任意的二維光強分布圖形,并將其投影到涂有光刻膠的基底上,實現所謂的“直寫”。
這一從“物理模板”到“數字光場”的轉變,帶來了革命性的優勢:
極致的靈活性與速度: 設計圖案的修改僅需在軟件中完成,幾分鐘內即可實現從設計到曝光的轉換,極大地縮短了研發迭代周期。這對于需要頻繁進行版圖驗證的科研工作,以及小批量、多樣化的產品試制至關重要。
顯著的成本效益: 省去了昂貴的掩模版制作、存儲和維護費用,使得小批量生產和個性化定制在經濟上成為可能。
強大的功能拓展性: DMD的每個微鏡不僅可以實現開/關二值調制,還能通過高速脈沖寬度調制實現多級灰度控制。這一能力使得無掩模光刻可以輕松實現灰度光刻,用于制造具有三維連續形貌的微光學元件(如菲涅爾透鏡、微透鏡陣列)和復雜的微流控通道等。

圖 澤攸科技ZML系列DMD無掩膜光刻機
在這一技術浪潮中,以澤攸科技為代表的科學儀器制造商,通過推出一系列桌面化的DMD無掩模光刻系統,將這一原本局限于特定領域的技術,推廣到了更廣泛的實驗室和研發機構。例如,其ZML系列無掩模光刻機,便體現了該技術在工程應用中的諸多考量。其采用高功率、高均勻度的LED作為曝光光源,結合DMD技術,能夠實現亞微米級別的分辨率。同時集成的CCD相機和自動對焦系統,實現了“所見即所得”的引導式曝光與精準套刻,大大降低了操作難度。對于工程師而言,這意味著可以更專注于器件設計與工藝開發,而非耗費大量精力在傳統光刻繁瑣的掩模對準等步驟上。

圖 澤攸科技DMD無掩膜光刻機部分應用案例
在實際應用中,澤攸科技的設備已被用于二維材料器件的電極制備、微流控芯片的快速成型、以及與電子束光刻(EBL)的混合套刻等前沿研究中,充分展現了其在快速原型制造和多功能集成方面的潛力。
在限制與自由之間做出選擇
光刻技術的發展史,就是一部不斷挑戰物理極限,并通過工程創新拓展應用邊界的壯麗史詩。從瑞利判據所揭示的理論限制,到浸沒式光刻、PSM、OPC等一系列精妙的工程解決方案,再到DMD無掩模光刻所帶來的全新設計自由度,我們看到的是一條從“遵循物理”到“駕馭物理”的清晰脈絡。
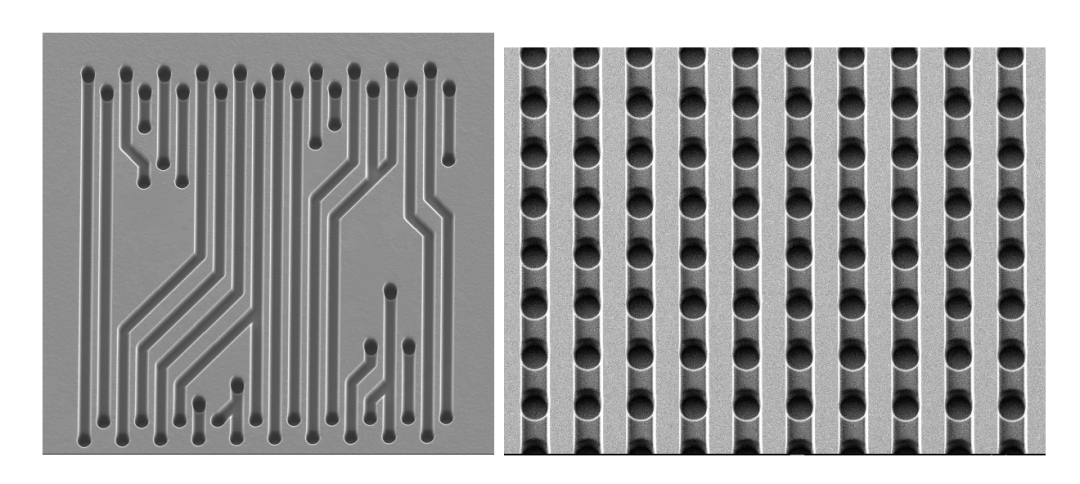
圖 無掩模光刻技術展示了同時對重新分布層(左)和過孔層(右)進行圖形化的能力
對于追求極致線寬、進行大規模量產的半導體前道制造而言,以EUV為代表的、配合復雜RETs的傳統掩模光刻仍是不可替代的主流。然而,在更廣闊的科研、教育、先進封裝、MEMS、生物芯片等領域,對研發效率、成本控制和設計靈活性的要求,往往超越了對極限分辨率的單一追求。
在這些場景下,以澤攸科技DMD光刻機為代表的無掩模技術,通過將光刻過程從依賴昂貴物理模板的“重資產”模式,轉變為由軟件定義的“輕量化”數字流程,為工程師和科研人員提供了一種高效、經濟且功能強大的新工具。它讓微納加工不再是少數尖端實驗室的專利,而是成為更多創新思想得以快速驗證和實現的平臺。最終技術的選擇并非簡單的優劣之分,而是在深刻理解其物理邊界和工程特性的基礎上,針對具體應用需求所做出的最明智的權衡。
參考資料
1、N. Takahashi, H. Kikuchi. “Rayleigh Criterion: The Paradigm of Photolithography Equipment.” Annals of Business Administrative Science 147 1 (2017): 203–213.
2、Liu, Junbo, et al. “The Inverse Optimization of Lithographic Source and Mask via GA-APSO Hybrid Algorithm.” Photonics, vol. 10, no. 6, June 2023, p. 638. Crossref,.
3、“The Rayleigh Criterion for Resolution.” ASML.
4、維基百科:角分辨率、沉浸光刻、Phase-shift mask、Optical proximity correction
5、Levinson, H. “Immersion Lithography and the Limits of Optical Lithography.” 2011. 0.
6、Mack, Chris A. “Resolution Enhancement Technologies.” The Lithography Expert, May 2003, Tutor41.doc, Version 12/9/03.
7、Yu, Haoyang, et al. “Optical Encryption by Dynamically Modulating the Spatial Frequency of Light Fields.” Optics Communications, vol. 560, June 2024, p. 130459. Crossref.
8、Derbyshire, Katherine. “Is Maskless Lithography Coming Into Its Own?” Semiconductor Engineering, 17 Aug. 2023.
作者:澤攸科技
